技術分享時間 | 芯片熱阻測量經驗總結【轉載】
2017-09-30 by:CAE仿真在線 來源:互聯網
芯片熱阻測量
IC 封裝的熱阻(Rjc, Rja),對于任何熱設計工程師,封裝設計及硬件工程師來說,都是非常耳熟的名詞,都期望能在規格書中找到齊全的熱阻參數,并且能夠精準。可現實中常難于如愿,熱阻參數除了不齊全外,有的還不一定準確,這困擾著不少工程師。
關于熱阻提取,興森研究院散熱公益顧問咨詢專家劉(水靈)工提出了自己的見解:當前要準確測量芯片的熱阻并非易事,或許也是眾多芯片廠家埋在心中的一個結。目前熱阻提取方法大概有三:
1 通過熱仿真提取
2 根據Jedec標準測量
3 通過瞬態熱測試儀T3ster
下面我們看看通過T3ster 測試儀來檢測芯片內部結構的熱阻的方法是否更為理想。我們也期待有更多的業界同仁參與探討。
首先還是讓我們了解下這個號稱熱測試中的“X射線” 神器-T3ster,一起揭開它的面紗。
一、T3ster簡介
T3ster是目前唯一滿足半導體熱阻模型測試標準的測試儀器;其開發者也是JESD51-14(半導體結殼熱阻?jc)測試方法制定者,可算是半導體熱阻測試的領導者。其獨創的結構函數分析法,能夠分析器件熱傳導路徑上每層結構的熱學性能(熱阻和熱容參數),構建熱學模型,是封裝工藝,可靠性試驗,材料特性以及接觸熱阻的強大支持工具,被譽為熱測試中的“X射線”;適應于IC,SOC,SIP,散熱器,熱管等熱特性測量分析。
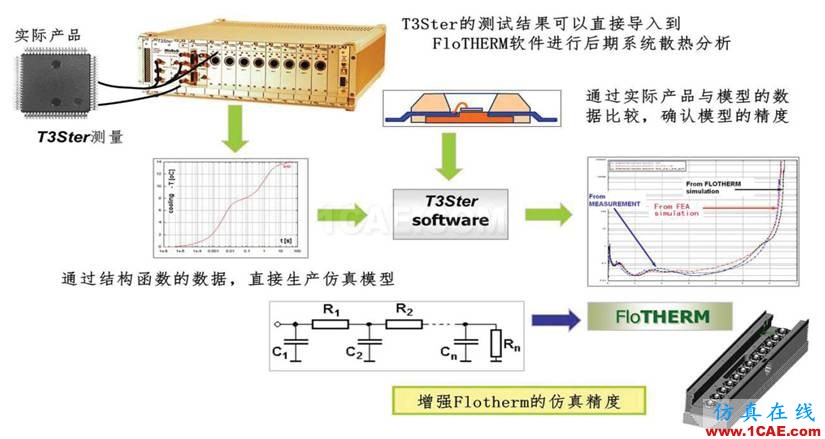
T3ster在電子產品中的應用
①驗證IC芯片散熱特性
-通過測試芯片die到封裝的熱阻,判斷芯片封裝散熱特性好壞。
②非破壞性測試驗證:
-芯片廠家沒提供熱阻參數或者提供的熱阻值與產品應用環境不一致
-T3ster不破壞芯片結構,通過靜態熱阻測量方法,測試芯片的熱阻
-可進行老化實驗分析、失效實驗分析
③T3ster的測試結果直接導入到Flotherm軟件進行后期系統散熱分析
④接觸熱阻的大小與材料、接觸質量關系密切
-芯片或散熱器的接觸熱阻有:導熱膠、導熱墊片、螺釘聯接、干接觸殼體等
-通過T3ster快速測試各種材料的接觸熱阻,驗證不同工藝的散熱效果。
⑤材料熱學性能的驗證
二、熱阻檢測案例
對3個同一批次芯片樣品進行熱瞬態測試,通過結構函數對芯片結構層熱特性進行對比分析。
樣品數量: 3pcs(#1,#2,#3)
器件類型: To220
測試設備: Mentor T3ster
測試地點: 興森科技&貝思科爾聯合實驗室
測試工程師:John Liu



說明:3個樣品分別放入T3ster恒溫槽里面,用同一導熱墊接觸,
導熱墊參數:厚1mm,K=5.5w/m-k
測試方法:one by one ;

對#1號樣品增加一組導熱硅脂的測試,如下圖所示:

K系數是什么?
是建立結溫與電壓之間的關系。
在器件本身的自發熱可以忽略的情況下,將器件置于溫度可控的恒溫環境中,改變環境溫度,測量TSP,得到一條校準曲線。該直線斜率即為K系數。
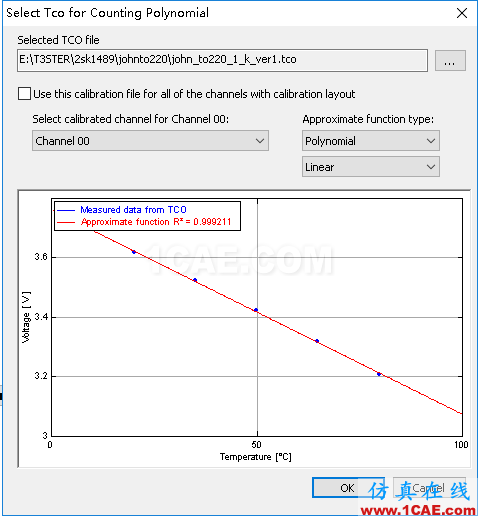
瞬態溫度響應曲線
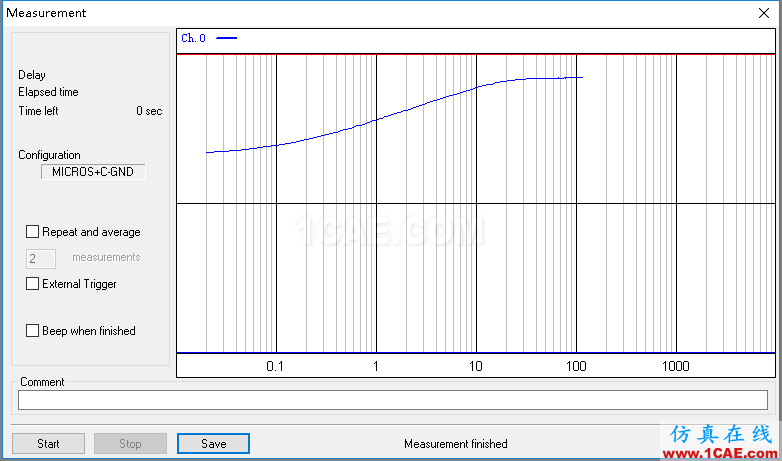
結構函數是軟件后處理分析的重點。什么是結構函數?
結構函數是描述封裝熱流路徑上的熱阻與熱容參數。
結構函數的獲取:通過T3ster對芯片熱相關參數的測試,得到芯片的溫度變化瞬態曲線,可以從溫度的變化曲線中通過數值變化得出其結構函數;
器件結構示意圖

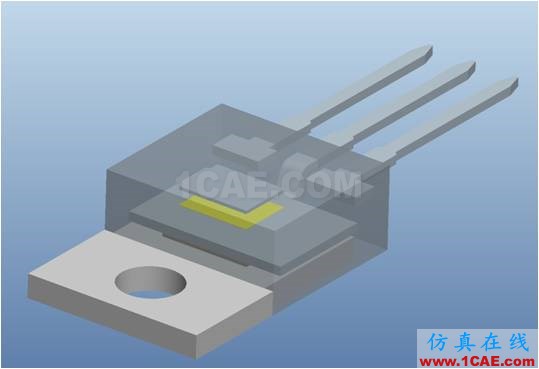
結構函數及簡化的熱阻模型
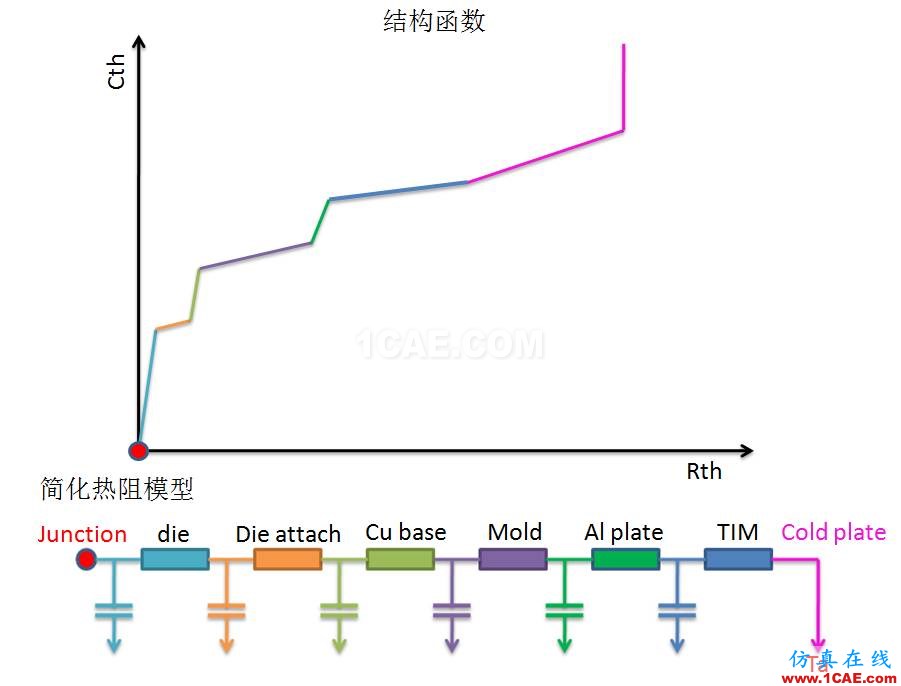
①下圖為樣品#1采用兩個不同的TIM材料所得的結構函數;
- 我們通過分析軟件可清晰的找到了兩曲線的交叉點,此點值正是芯片的結殼熱阻。交叉點前端曲線為芯片內部結構層熱阻,從圖看幾乎是完全重合。由于是同一個芯片,所以理論上應該是重合的。當然假設同一個芯片工作久了在拿過來測,或許就會差別較大了,這也就是通常我們所說的芯片老化,疲勞帶來的品質問題。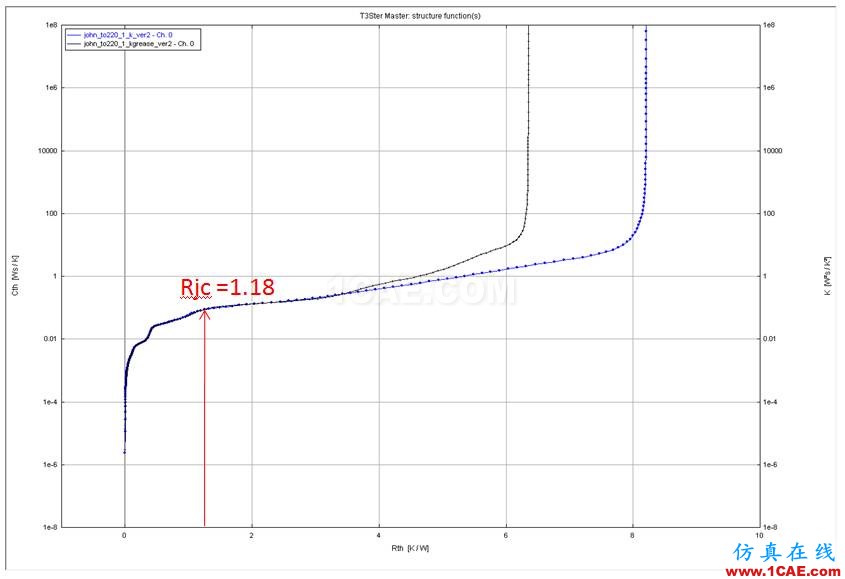
②3個樣品測試的結構函數
從下圖可看出,#1,#2,#3三個芯片的結構函數是不重合的,結殼熱阻也有所不同:
- 由于IC封裝里面每個結構層的尺寸,工藝控制多少有些差異,或是焊接層空洞等多方面因素導致其各層熱阻的差異,通過同批次多數量的熱阻檢測,可以分析芯片熱管理的可靠性。
- TIM層熱阻差異主要由于每次測量時壓力不同導致。
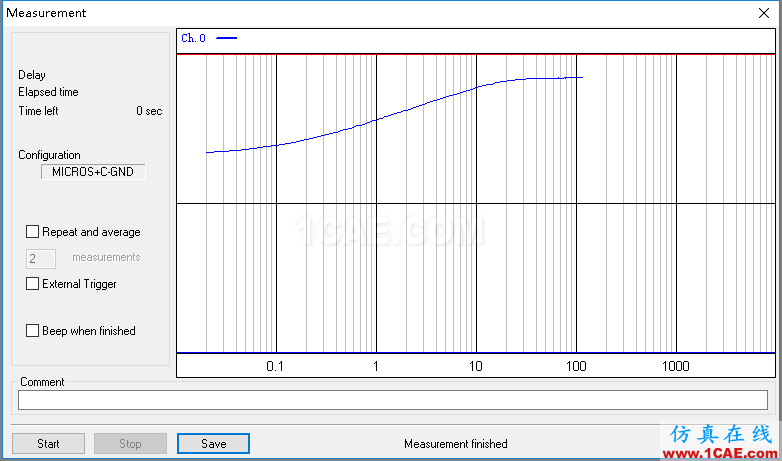
相關標簽搜索:技術分享時間 | 芯片熱阻測量經驗總結【轉載】 HFSS電磁分析培訓 HFSS培訓課程 HFSS技術教程 HFSS無線電仿真 HFSS電磁場仿真 HFSS學習 HFSS視頻教程 天線基礎知識 HFSS代做 天線代做 Fluent、CFX流體分析 HFSS電磁分析






